- TOP
- TOP続
- TOP続々
- ブログ
- 会社情報
- 会社案内
- 沿革-1
- 沿革-2
- 設備一覧
- 分析機器一覧①
- 分析機器一覧②
- 塗装技術
- 製品一覧-1
- 製品一覧-2
- めっきとは?
- めっきとは?続編
- 錫めっき製品(光沢あり)-1
- 錫めっき製品(光沢あり)-2
- 錫めっき製品(光沢あり)-3
- 錫めっき製品(光沢なし)-1
- 錫めっき製品(光沢なし)-2
- 錫めっき製品(光沢なし)-3
- 錫めっき製品(光沢なし)-4
- 銀めっき製品-1
- 銀めっき製品-2
- 亜鉛めっき製品-1
- 亜鉛めっき製品-2
- 亜鉛めっき製品-3
- 亜鉛めっき製品-4
- ニッケルめっき製品-1
- ニッケルめっき製品-2
- ニッケルめっき製品-3
- ニッケルめっき製品-4
- ニッケルめっき製品-5
- ニッケルめっき製品-6
- カチオン電着塗装製品
- キリンス・脱脂処理製品-1
- キリンス・脱脂処理製品-2
- キリンス・脱脂処理製品-3
- キリンス・脱脂処理製品-4
- 部分めっき/半導体製品
- クリア塗装製品
- 硬質クロムめっき製品
- 無電解ニッケルめっき製品
- パ-カ-ライジング(黒染め)
- 硬質アルマイト処理製品
- 金めっき製品
- 資料ダウンロ-ド-1
- お問い合わせ
- CSR活動
- 動画ライブラリ
- 写真集
- アクセス
- LINK-1
- LINK-2
■分析機器一覧②
⑥蛍光X線膜厚測定装置 SFT9200『SIIセイコ-インスツルメンツ』 XRF Coating Thickness Gauge
◆Specification
■測定元素:原子番号Ti(22)~Bi(83)
■線源:
●小型空冷X線管(Wターゲット、Be窓)
●管電圧45kV
●管電流1mA
■検出器:比例計数管
■コリメータ(〇型)
●0.025、0.05、0.1、0.2、0.3(mmφ)
■試料観察:CCDカメラ
■測定ソフト:薄膜FP法(最大5層膜、10元素)
検量線法
■安全機能:試料扉インターロック、
試料の衝突防止機能、装置診断機能
■焦点合わせ:レーザーポインタ-
■フィルタ:
*一次フィルタ:Al-自動切替
*二次フィルタ:Co-自動切替
■試料ステージ:
*(テーブル寸法)X:430,Y:330(mm)
*(移動量)X:400,Y:300,Z:50(mm)
■装置寸法:
*520(W)×600(D)×445(H) mm
◆Canonレ-ザ-プリンタ-接続
めっき済み製品にX線を照射し、そこから得られる蛍光X線のエネルギーおよび強度から、めっきの膜厚測定 や金属材料等の定性分析を行う装置です。本装置は試料にX線を照射することにより、非破壊で膜厚 測定や定性分析が可能です。また断面観察と比較し短時間で膜厚測定が可能です。
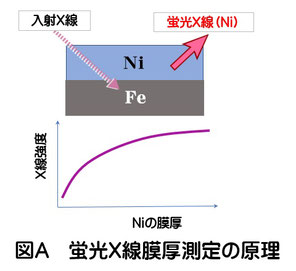
蛍光X線による膜厚測定は、非破壊で1µm以下の膜厚や
多層めっきも測定可能であるという特徴を持っています。
鉄材のニッケルめっきにX線を照射すると、めっき厚が厚くなる
ほどニッケルめっきから放出されるX線(蛍光X線)強度が
増加します。「図A」あらかじめ膜厚既知の標準試料を測定し、
膜厚と蛍光X線の強度の関係を把握する事(検量線法)又は、理論計算(薄膜FP法)により、ニッケルめっきの膜厚を測定します。下記表Bは主な元素の測定可能範囲の上限値及び
下限値を示したものです。
表B 主な元素の測定可能膜厚
| 原子番号 | 元素記号 | 分析線 | 下限 µm | 上限 µm |
|
22 |
Ti | K㌁ | 0.01 | 10 |
| 24 | Cr | K㌁ | 0.01 | 10-12 |
| 28 | Ni |
K㌁ |
0.01 | 23 |
| 30 | Zn | K㌁ | 0.01 | 30-40 |
| 46 | Pd | K㌁ | 0.01 | 80-100 |
| 50 | Sn | K㌁ | 0.01 | 50 |
| 79 | Au | Lベ-タ | 0.005 | 6 |
| 82 | Pb | Lベ-タ | 0.005 | 10 |